| 일 | 월 | 화 | 수 | 목 | 금 | 토 |
|---|---|---|---|---|---|---|
| 1 | ||||||
| 2 | 3 | 4 | 5 | 6 | 7 | 8 |
| 9 | 10 | 11 | 12 | 13 | 14 | 15 |
| 16 | 17 | 18 | 19 | 20 | 21 | 22 |
| 23 | 24 | 25 | 26 | 27 | 28 |
- 반도체소자
- 반도체공정
- doping
- oxidation
- mechanism
- 부피결함
- She
- high bandwidth memory
- DRAM
- Silicon on Insulator
- SK하이닉스
- HBM
- SOI MOSFET
- ion implantation
- effective mass
- Short Channel Effect
- Punch through
- Warpage
- GIDL
- feol
- finFET
- RCAT
- Energy Band
- 반도체 8대공정
- 양자역학
- Threshold Voltage
- 선결함
- 반도체공학
- Dynamic Random Access Memory
- MOSFET
- Today
- Total
반도체 공부 기록
[반도체공정(FEOL)] Doping #02 - Ion implantation(IMP) 본문
Doping
반도체 소자 미세화에 따라 피치 사이즈는 점차 작아졌습니다. 반도체의 전기적 특성을 결정하는 Doping 공정 중 하나인 Diffusion은 고온의 열이 필요합니다. 소자가 작아짐에 따라 수평 방향으로의 확산으로 전기적 특성을 정확하게 구분하기 어려워졌습니다. 또, Short channel effect를 막고자 국부적으로 높은 농도의 Dopant가 요구되는 영역이 필요해졌습니다. (Punch through를 막기 위한 Halo doping 또는 Retrograde doping) 반대로 낮은 농도가 요구되는 경우 Diffusion 공정을 이용하면 Dopant delivery와 Uniformity의 문제가 있습니다. Diffusion 공정은 고용도(Solid solubility)의 한계로 임계 농도 이상의 Dopant를 주입할 수 없는 문제에 직면하게 되었습니다. 이를 극복하기 위해 Ion implantation 기술이 도입되었습니다.
♭ Ion implantation

Ion implantation은 이온을 가속시켜 반도체 기판에 물리적으러 이온을 주입시키는 방식입니다. 이온 주입 매커니즘에 대해 알아보기 위해 장비 구조와 함께 알아보겠습니다.
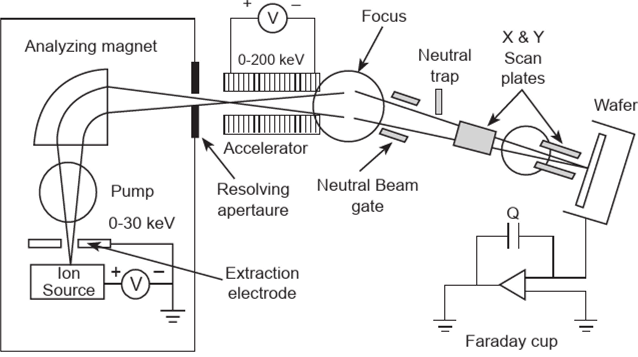
1. 진공장치 : 10-7 ~ 10-8 torr
→ 이온을 원하는 농도, 깊이로 주입하기 위해 가속된 에너지를 기체 분자의 충돌에 의해 손실되지 않기 위해 진공을 유지한다.
2. 이온 공급 장치 : 양이온 공급

→ Hot filament에서 방출된 열전자를 가속시켜 중성 원자에 충돌시켜 양이온 공급
(Dopant를 이온으로 하전시켜 Dopant의 거동을 전자기력으로 제어)
3. 분류기 : 원하는 이온 선택
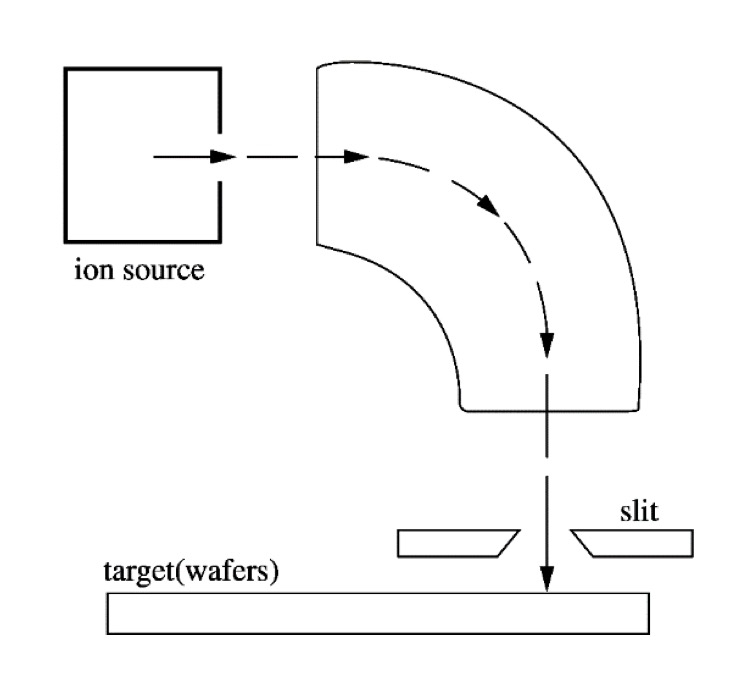
→ 이온의 질량 M과 전하량 q에 따른 로런츠 힘에 의해 원하는 이온만 Slit 사이로 통과
(자기력을 이온이 운동하는 구심력으로 이용)
4. 가속기 : 이온을 가속시켜 충분한 운동에너지 공급
→ 반도체 격자와 충돌하면서 에너지를 잃고 원하는 위치에 이온을 공급
1) 선 분류 방식 : 이온 공급 장치에서 나온 이온들을 분류하여 최종 에너지까지 가속
2) 후 분류 방식 : 최종 에너지까지 가속시킨 후 분류
5. 집속기 : 수 mm ~ 1 cm 직경의 집속빔 형성
→ 정전장 렌즈 또는 자장 렌즈를 이용하여 Beam size와 spec.을 결정
6. 중성빔 포획 장치 : Doping uniformity를 개선
→ 중성 원자가 주입되는 경우 Doping uniformity를 악화시켜 중성 원자를 제거
7. 주사 장치 : 이온 주사(scanning)
-> 반도체 격자의 원하는 위치에 이온을 주입
1) X-Y 주사법 : Scanner 위치(X/Y축) 변화 (Wafer 고정)
2) 기계적 주사법 : Wafer 위치(X/Y축) 변화 (Scanner 고정)
3) 혼합 주사법 : Scanner X축 변화 + Wafer Y축
8. 이온 주입실 : 실제 이온이 주입되는 위치
1) QT < 1013cm-2 : 10초 이내 이온 주입
→ 대부분의 시간을 진공을 형성하는 소요 (Vaccum pump 성능 향상 필요)
2) QT > 1013cm-2 : 진공 형성이나 Wafer handling보다 이온 주입 시간이 길다
→ 대부분의 시간을 이온 주입에 소요 (High current implanter 요구)
9. Faraday cup : 기판에서 방출되는 전자나 이온을 잡아주는 장치
→ 전자나 이온은 Ion implantation을 방해하기 때문에 제거
♭ Ion distribution
LSS(Lindhard, Scharff, Schiott) 이론에 따라 가속된 이온은 반도체 격자 내부의 원자와 지속적으로 충돌하면서 에너지를 잃고 멈추게 됩니다. 주입된 이온 프로파일은 가우시안 분포를 따르게 됩니다.
1) 가속전압

주입되는 이온의 가속 전압이 커질수록 침투 깊이는 깊어지고, 가우시안 분포의 편차는 증가합니다.
2) 가우시안 분포의 비대칭성

Rp: 표면에서의 수직거리 평균치
- 주입된 이온 질량 > 격자 원자 질량
운동량 교환 법칙에 의해 주입된 이온은 Forward scattering이 우세하게 나타나며 에너지를 잃게 됩니다.
→ 가우시안 분포가 Rp값을 기준으로 더 깊은쪽으로 치우쳐져 있다.
- 주입된 이온 질량 < 격자 원자 질량
운동량 교환 법칙에 의해 주입된 이온은 Back scattering이 우세하게 니타나며 에너지를 잃게 됩니다.
→ 가우시안 분포가 Rp값을 기준으로 더 얕은쪽르로 치우쳐져 있다.
같은 가속 전압으로 이온을 주입했을 때 질량이 낮을수록 더 깊게 주입된다.
3) Channeling effect

실리콘 [111] 방향에서 0~12도 까지의 각도를 가지고 450keV 가속전압으로 P를 주입할 때의 이온 분포입니다.

단결정 격자는 특정 방향에서 이온을 주입할 때 격자에 존재하는 원자와 충돌이 적어 가속 전압에 비해 더 깊은 깊이 이온이 주입된다.
1) Shadow effect
반도체 기판을 7-8도 Tilt하여 주입된 이온이 격자에 존재하는 원자와 충돌할 수 있도록 하여 Channeling effect를 방지한다.
2) Sacrifical oxide
반도체 기판 위에 희생 산화막을 쌓아 이온이 주입될 때 무작위한 방향으로 반도체 기판에 진입하여 Channeling effect를 방지한다.
3) Pre-amorphization
단결정 반도체 기판 표면의 일부 깊이를 비정질화하여 이온이 주입될 때 Channeling effect를 방지한다.
♭ Annealing
Ion implantation은 물리적 에너지에 의해 이온이 격자 내부로 주입되는 방법입니다. 이때 주입된 이온은 격자의 Substitutional site가 아닌 Interstitial site에 존재하여 Dopant 역할을 수행하지 못하고, 이온 충돌에 의해 격자 손상이 발생합니다. 손상된 격자는 전자나 정공이 이동될 때 Trap되는 Defect으로 작용하여 이동도를 떨어뜨립니다.
RTP를 통해 짧은 시간동안 열을 인가하여 주입된 이온이 Substitutional site로 활성화(Activation)시키고, 격자 손상을 재결정화하여 회복(Curing/Recovery)시킵니다.
*Transient Enhanced Diffusion (TED)
낮은 온도에서 손상된 격자에 의해 확산이 빠르게 일어나는 현상으로 열처리를 통해 방지합니다.
출처)
-Stanford advanced materials
-Integrated circuit fabrication
-H. S. Yoon, S. J. Kim, "VLSI process technology" .
'반도체 전공정(FEOL)' 카테고리의 다른 글
| [반도체공정(FEOL)] Doping #01 - Diffusion (0) | 2024.06.09 |
|---|---|
| [반도체공정(FEOL)] Oxidation #03 - Application (2) | 2024.06.03 |
| [반도체공정(FEOL)] Oxidation #02 - Oxidation variable (0) | 2024.05.29 |
| [반도체공정(FEOL)] Oxidation #01 - Deal Grove model (0) | 2024.05.29 |
| [반도체공정(FEOL)] Wafer fabrication #03 (0) | 2024.05.23 |




